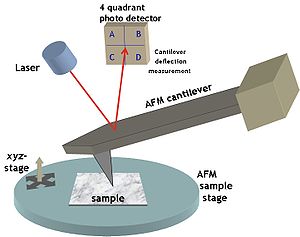
Atomkraftmikroskop (AFM) är en typ av mikroskop. AFM ger bilder av atomer på eller i ytor. Precis som skanningselektronmikroskopet (SEM) är syftet med AFM att titta på objekt på atomnivå. Faktum är att AFM kan användas för att titta på enskilda atomer. Det används ofta inom nanoteknik.
AFM kan göra vissa saker som SEM inte kan göra. AFM kan ge högre upplösning än SEM. Dessutom behöver AFM inte arbeta i vakuum. AFM kan faktiskt arbeta i luft eller vatten, så den kan användas för att se ytor på biologiska prover, t.ex. levande celler.
AFM fungerar med hjälp av en ultrafin nål som är fäst vid en klyvningsbalk. Spetsen på nålen löper över åsar och dalar i det material som avbildas och "känner" av ytan. När spetsen rör sig uppåt och nedåt på grund av ytan böjs klyvbäraren. I en grundläggande konfiguration lyser en laser på klyftan i en sned vinkel och gör det möjligt att direkt mäta klyftans avböjning genom att helt enkelt ändra laserstrålens infallsvinkel. På detta sätt kan man skapa en bild som avslöjar konfigurationen hos de molekyler som avbildas av maskinen.
Det finns många olika driftlägen för en AFM. Ett är "kontaktläget", där spetsen helt enkelt flyttas över ytan och utböjningen av karmledaren mäts. Ett annat läge kallas "tappningsläge", eftersom spetsen knackas mot ytan när den rör sig längs med den. Genom att styra hur hårt spetsen knackas kan AFM:n flytta sig bort från ytan när nålen känner en ås, så att den inte slår mot ytan när den rör sig över den. Det här läget är också användbart för biologiska prover, eftersom det är mindre sannolikt att den skadar en mjuk yta. Detta är de grundläggande lägena som oftast används. Det finns dock olika namn och metoder som "intermittent kontaktläge", "icke-kontaktläge", "dynamiskt" och "statiskt" läge med mera, men dessa är ofta variationer på de ovan beskrivna tapp- och kontaktlägena.
Principer och huvudkomponenter
En AFM består i grunden av följande delar:
- Spets (tip): en mycket vass nål (vanligtvis kisel eller kiselkarbid) som rör vid eller kommer i nära kontakt med ytan. Tipradien bestämmer i hög grad den laterala upplösningen (vanligtvis några få nanometer).
- Klyvningsbalk (cantilever): en liten flexibel balk som spetsen sitter på. När spetsen påverkas av ytan böjer sig balken.
- Lasersystem och positionssensor: en laserstråle reflekteras från klyvningsbalkens baksida till en fyrkantsfotodiod som registrerar vertikal och ibland lateral avböjning.
- Piezo-elektrisk skanner: flyttar provet (eller spetsen) i x, y och z med mycket hög precision för att skanna ytan.
- Elektronik och feedbackkrets: håller ett styrvärde konstant (t.ex. kraft eller oscillationsamplitud) genom att flytta skannern i z; detta skapar topografidata.
Principen bygger på att avböjningen av klyvningsbalken eller förändringen i dess oscillation svarar mot interaktioner mellan spetsen och provytan (kontakträcker, van der Waals-krafter, kapillärkrafter, elektrostatiska krafter med mera). Genom att läsa av dessa signaler och använda en feedbackloop fås en topografisk karta eller andra egenskapskartor.
Vanliga driftlägen (översikt och skillnader)
- Kontaktläge: Spetsen ligger i nära kontakt mot ytan och avböjningen av klyvningsbalken mäts. Ger god upplösning men kan slita på mjuka prover eller spetsen.
- Tappningsläge (intermittent kontakt): Klyvningsbalken oscillerar och spetsen "knackar" lätt mot ytan vid varje svängning. Minskar lateral dragkraft och är skonsammare mot biologiska eller mjuka prover.
- Icke-kontaktläge: Spetsen vibrerar nära ytan utan att slå mot den; förändringar i oscillationsfrekvens eller amplitud används för att bilda bilden. Bra för mycket känsliga ytor.
- Statiskt och dynamiskt: Statiska lägen mäter kontinuerlig avböjning; dynamiska lägen använder oscillerande klyvningsbalk för att öka känslighet mot mindre krafter.
- Kontaktbaserade kartor: t.ex. lateral force microscopy (LFM) som mäter friktion och glidkrafter.
- Speciallägen för egenskapsmätning: force spectroscopy (mätning av kraft vs. avstånd för att bestämma adhesion och elasticitet), conductive AFM (mappning av lokala elektriska ledningar), magnetic force microscopy (MFM, kartlägger magnetfält), Kelvin probe force microscopy (KPFM, yta-potential), och elektro-kemisk AFM för mätningar i vätskor.
Användningsområden
AFM är ett mångsidigt verktyg som används inom många fält:
- Materialvetenskap: yttopografi, nanostrukturering, analys av tunna filmer, sprickbildning, nötning och tribologi.
- Nanoteknik och nanofabricering: manipulering av nanopartiklar, litografi på nanoskala och mätning av nanoelektroniska komponenter.
- Biologi och biofysik: avbildning av celler, membran, proteiner och DNA i luft eller flytande miljö; mätning av mekaniska egenskaper hos biomolekyler och celler.
- Elektronik: kartläggning av ledningsförmåga och ytladdningar i halvledarmaterial och nanokomponenter.
- Kemi och polymerer: fasbildning, ytråhet, mätning av adhesiva och mekaniska egenskaper i polymera material.
Fördelar och begränsningar
- Fördelar: extrem vertikal upplösning (sub-ångström i vissa fall), möjligheten att arbeta i luft eller vätska, kombinationen av topografi och lokala egenskaper (mekaniska, elektriska, magnetiska), ingen nödvändighet för vakuum.
- Begränsningar: relativt långsam mätning jämfört med optiska tekniker, begränsad skannarea (typiskt <100 µm), brus och artefakter beroende på tippslitage eller konfigurationer, svår tolkning av vissa signaler utan erfarenhet.
Praktiska råd vid användning
- Välj rätt spets och klyvningsbalk (springkonstant) för provets styvhet: mjuka prover kräver mjukare balkar (lägre k), hårda prover kräver styvare balkar.
- Kalibrera skannern och läs- och z-skalor regelbundet för kvantitativa mätningar.
- Rengör provet noggrant och minimera lösa partiklar för att undvika tippskador.
- Justera feedbackparametrar (gain, setpoint) för att minimera artefakter: för höga gains kan ge oscillationer, för låga ger spårfördröjning.
- Arbeta i lämplig miljö (t.ex. vibrationsdämpning, temperaturkontroll) för bästa upplösning.
Historia och utveckling
AFM uppfanns 1986 av Gerd Binnig, Christoph Gerber och Calvin Quate (samma Binnig som meduppfann STM). Tekniken har sedan dess utvecklats kraftigt: snabbare elektroniska system, mer hållbara och specialiserade spetsar, och nya lägen (elektriska, magnetiska, kemiska mätningar) har gjort AFM till ett av de mest använda instrumenten inom nanovetenskap.
Tolkning och artefakter
Vid tolkning av AFM-bilder bör man vara medveten om några vanliga artefakter:
- Tippslitage eller dubbeltoppar om spetshuvudet skadas.
- Höjd- och lateralutvidgningseffekter beroende på tippradie (konvolutionsproblem).
- Hysteresis i piezo-skannern som ger geometriavvikelser om den inte kompenseras.
- Kraftpåverkan på mjuka prover som kan deforma ytan och förändra bilden.
Sammanfattningsvis är AFM ett kraftfullt verktyg för att avbilda och mäta ytegenskaper på nanoskala med hög precision och mångsidighet. Valet av driftläge, spets och experimentella parametrar avgör både vilken information som kan erhållas och hur skonsamt provet kan avbildas.